除了宣布下一代HBM3E高带宽内存可以做到单颗芯片36GB、等效频率9.8GHz的世界领先,三星还展望了真正全新一代HBM4内存的方向。
在三星的规划中,HBM4将有两个发展方向,使用更先进的晶体管工艺和更高级的封装技术。
工艺方面,三星计划在HBM上放弃传统的平面晶体管,改用FinFET立体晶体管,从而降低所需的驱动电流,改善能效。
FinFET立体晶体管技术是Intel 22nm率先引用的,这些年一直是半导体制造工艺的根基,接下来在Intel 20A、台积电2nm、三星3nm上,都将转向全环绕立体栅极晶体管。
封装方面,三星计划从微凸点键合转向无凸点键合(bumpless bongding),将铜层与铜层直接互连。
事实上,这在逻辑芯片领域也是相当先进的技术,仍在研发之中。
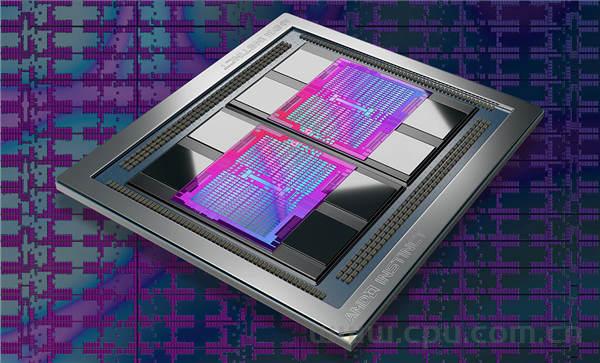
显然,这些都有助于HBM内存继续扩大容量、提升频率和带宽,但成本也将居高不下,注定它不会和普通用户产生多大关联,依然是HPC、AI领域的专属。